高性能氮化镓(GaN)金属氧化物半导体(MOS)晶体管离不开具有低界面态和低漏电流的高质量MOS结构。然而,与SiO2/Si体系相比,氧化物/GaN较差的界面特性以及GaN表面缺乏高质量、稳定的本征氧化物,一直是实现高质量GaN MOS晶体管的主要障碍。Al2O3因其优异性能以及与GaN良好的导带和价带偏移而被视为一种替代选择。

确保GaN MOS器件中高质量绝缘体和Al2O3/GaN界面对于防止由电荷陷阱和固定电荷引起的性能退化至关重要。湿法刻蚀预处理和沉积后退火工艺常用于钝化GaN表面,但其改善效果仍然有限。此外,诸如O2、N2、F、NH3和N2O等离子体处理也被研究用于增强Al2O3/GaN界面。然而,等离子体处理技术可能对GaN表面造成不可逆损伤。对于实现高性能GaN MOS器件,稳定且低损伤的MOS界面增强技术仍是迫切需求。
本研究开发了一种可控且低损伤的GaN表面钝化技术。我们采用氢化物气相外延(HVPE)技术,成功生长了低位错密度(~1.5×106 cm-2)的单晶氮化镓衬底及其外延层,这些材料被用于制造高质量的垂直氮化镓MOS电容器。通过引入硫钝化和等离子体增强原子层沉积(PEALD)生长的高质量GaOx中间层,所制备的高性能Al2O3/GaN MOS电容器展现出低界面态密度(Dit)约8×1010 cm-2·eV-1,以及的低平带电压漂移(ΔVFB)约20 mV。此外,引入GaOx中间层能有效降低漏电流(在+10 V偏压下,从约10-3 A/cm2降至约10-6 A/cm2)。
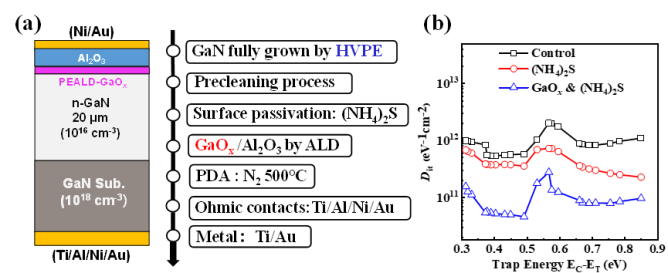
图1.具有GaOx层的垂直GaN MOS电容(a)结构示意图及关键工艺,(b)器件的界面态密度参数提取。
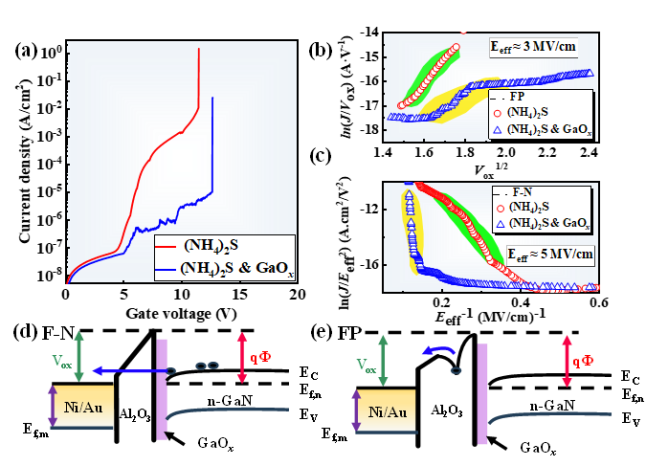
图2.(a)氮化镓MOS电容正向J-V曲线,(b)和(c)氮化镓MOS电容漏电机制拟合,(d)和(e)氮化镓MOS漏电机制示意图。
团队介绍
刘新科,深圳大学功率半导体器件及AI能源监测工程技术研究所所长,材料学院、射频异质异构集成全国重点实验室研究员,英国物理学会会士(FInstP,2025),英国皇家化学会士(FRSC,2024),博士研究生导师。一直从事宽禁带半导体氮化镓材料与器件的研究工作,以第一作者/通讯作者在国际学术期刊Materials Today、Advanced Materials、IEEE EDL/TED等发表121篇SCI论文,在IEDM、ISPSD、IEEE EDL/TED、APL、JAP国际知名学术期刊/顶级会议发表文章共计28篇。主持国家科技部重点研发计划项目、国家自然科学基金(青年和面上)、广东省自然科学基金杰出青年项目等重要科研项目。作为第一完成人或个人, 2021年度广东省高校科技成果转化总决赛铜奖、2022年广东省科技进步二等奖、2022年中国电子学会科技进步二等奖、2022年广东省电子学会科技进步二等奖、2023年深圳市青年科技奖。
文章信息
Vertical Al2O3/GaN MOS capacitors with PEALD-GaOx interlayer passivation
Renqiang Zhu; Jinpei Lin; Hong Gu; Lixuan Chen; Bo Zhang; Hezhou Liu; Xinke Liu
Appl. Phys. Lett. 126, 081603 (2025)
https://doi.org/10.1063/5.0245266
来源:AIPP
